소성형 Paste
CuAgTi계
도체 Paste(CuAgTi계)
제품 상세 정보
특징
- 상층에 구리 페이스트를 겹겹이 쌓으면 0.3mm 이상의 매우 두꺼운 막을 형성할 수 있습니다.
- Pb, Cd와 같은 환경 유해 물질을 포함하지 않습니다.
- 내열성, 내충격성, 신뢰성이 뛰어납니다.
- 금속 막과 기판은 강한 화학 결합을 형성하여 Si₃N₄ 및 AlN 기판에 대한 우수한 접착력을 제공합니다.
구조
-
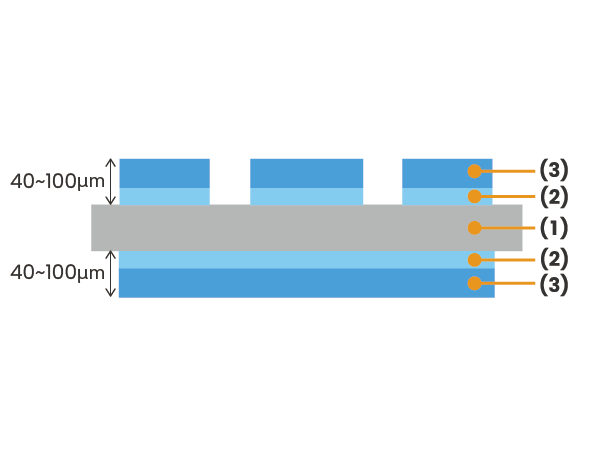
100μm 미만의 필름 두께
■프로세스
(1) 접착층 인쇄(AS112)
(2) 접착층의 상층 인쇄(DC014GL)
(3) 소성(예: 850℃, N₂ 분위기) -
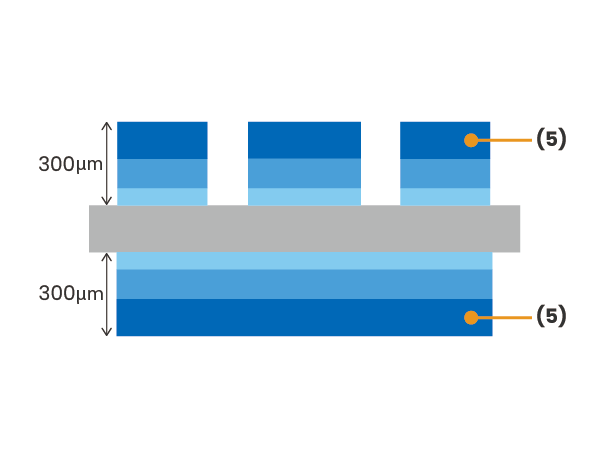
필름 두께 100μm 이상
필름 두께가 100μm 이상인 경우, 다음 공정이 추가됩니다.
■공정
(4) 두꺼운 층(GL39) 인쇄
(5) 800℃, N₂ 분위기에서 소성
-

발화 후의 기질 이미지
구리 페이스트 두꺼운 필름(50μm)을 활성 금속 페이스트를 결합층으로 사용하여 소성된 기판.
(1) SiN
(2) 구리 -
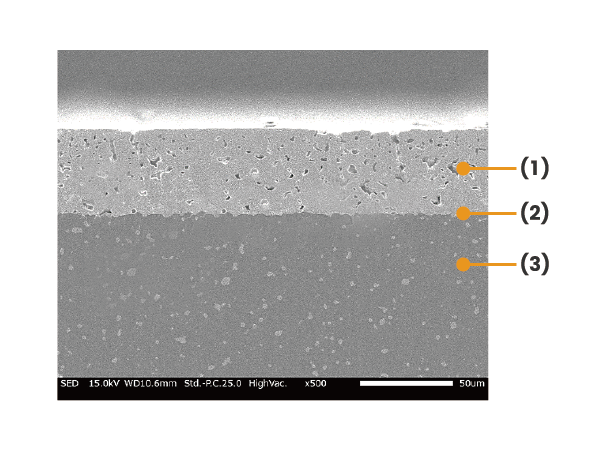
단면 SEM 이미지
소성 후 기판 이미지
(1) 구리 필름
(2) 활성 금속 함유 결합층(구조식: Ti5Si3)
(3) SiN 기판
적용 사례
-
- 전력 장치용 세라믹 열 방출 회로 패키지
- 고신뢰성이 요구되는 세라믹 회로 기판 및 세라믹 패키지
사양
| 형번 | 필름 두께 | 용도 | 특징 | 도체 성분 | 접착력 (N/2mm□) | 권장 소성 조건 | 코팅 방법 | 대응 기판 | |
|---|---|---|---|---|---|---|---|---|---|
| 100μm< | 100μm≧ | ||||||||
| AS112 | ○ | ○ | 후막 전도체 배선, 전극 형성(세라믹 기판과의 접합층) | 높은 접착력, 높은 열 안정성 | Ag, Cu, Ti |
≧30 |
850 °C 10min, |
스크린 인쇄 | Al₂O₃, AlN, Si₃N₄ |
| DC014GL | ○ | ○ | 후막 도체 배선, 전극 형성 | 높은 표면 평활성, 단일 인쇄로 더 큰 필름 두께 형성 가능 | Cu | - | 850 °C 10min, In N₂ |
스크린 인쇄 | Al₂O₃, AlN, Si₃N₄ |
| GL39 | - | ○ | 초박막 필름 도체 배선, 전극 형성(다층 두께 증가용) | 한 번의 인쇄로 더 두꺼운 필름 두께 형성 가능 | Cu | - | 800 °C 10min, In N₂ |
스크린 인쇄 | Al₂O₃, AlN, Si₃N₄ |
주의 사항
- 질소 분위기에서 소성해야 합니다.
- 각 제품의 물질안전보건자료(SDS)를 확인하시기 바랍니다.
비고
질소 치환로가 없는 경우, 위탁 소성이 가능합니다. 저희에게 연락 주시기 바랍니다.

